微機(jī)電系統(tǒng)(MEMS)屬于21 世紀(jì)前沿技術(shù),是對(duì)MEMS加速度計(jì)、MEMS 陀螺儀及慣性導(dǎo)航系統(tǒng)的總稱。MEMS 器件特征尺寸從毫米、微米甚至到納米量級(jí),涉及機(jī)械、電子、化學(xué)、物理、光學(xué)、生物、材料等多個(gè)學(xué)科。在產(chǎn)品的研制方面,能夠顯著提升裝備輕量化、小型化、精確化和集成化程度,因此應(yīng)用極為廣泛。MEMS 產(chǎn)品制造與經(jīng)典的IC 最大區(qū)別在于其含有機(jī)械部分,封裝環(huán)節(jié)占整個(gè)器件成本的大部分,如果在最終封裝之后測(cè)出器件失效不但浪費(fèi)成本,還浪費(fèi)了研究和開發(fā)(R&D)、工藝過(guò)程和代工時(shí)間,因此,MEMS產(chǎn)品的晶圓級(jí)測(cè)試在早期產(chǎn)品功能測(cè)試、可靠性分析及失效分析中,可以降低產(chǎn)品成本和加速上市時(shí)間,對(duì)于微機(jī)電系統(tǒng)產(chǎn)業(yè)化非常關(guān)鍵。
晶圓級(jí)測(cè)試技術(shù)應(yīng)用于MEMS產(chǎn)品開發(fā)全周期的3個(gè)階段:(1)產(chǎn)品研發(fā)(R&D)階段:用以驗(yàn)證器件工作和生產(chǎn)的可行性,獲得早期器件特征。(2)產(chǎn)品試量產(chǎn)階段:驗(yàn)證器件以較高成品率量產(chǎn)的能力。(3)量產(chǎn)階段:最大化吞吐量和降低成本。本文分析了國(guó)內(nèi)和國(guó)際MEMS晶圓級(jí)測(cè)試系統(tǒng)硬件和系統(tǒng)技術(shù)現(xiàn)狀,參照下表中的RM 8096和RM 8097,給出了國(guó)內(nèi)現(xiàn)有問(wèn)題的解決方案。

MEMS晶圓級(jí)測(cè)試系統(tǒng)硬件
1. 測(cè)試系統(tǒng)
正如引言所說(shuō),一般MEMS產(chǎn)品的成品率比IC產(chǎn)品要低很多,成本分析發(fā)現(xiàn)60%~80%的制造成本來(lái)自于封裝階段,圖1中當(dāng)成品率為50%時(shí),采用晶圓級(jí)測(cè)試的芯片能節(jié)省30%總成本,可見(jiàn)采用晶圓級(jí)測(cè)試技術(shù),可以極大降低MEMS量產(chǎn)成本,提高器件可靠性。
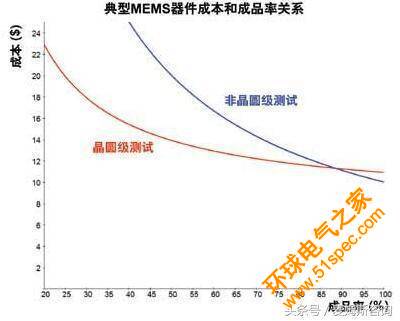
圖1 有無(wú)晶圓級(jí)測(cè)試條件下總成本對(duì)比
國(guó)際上主流的MEMS開發(fā)廠商,如美國(guó)的德州儀器(TI)、模擬器件(ADI)、飛思卡爾半導(dǎo)體(Freescale)、Silicon Microstructures(SMI)公司,歐洲的Robert Bosch、意法半導(dǎo)體(ST),日本的豐田電裝(DENSO)、歐姆龍(Omron)公司等均配備與MEMS晶圓級(jí)產(chǎn)品配套測(cè)試系統(tǒng)。
國(guó)內(nèi)而言,某些高校均建立了服務(wù)于自身MEMS生產(chǎn)線的晶圓級(jí)測(cè)試系統(tǒng),如清華大學(xué)、北京大學(xué)、復(fù)旦大學(xué)、東南大學(xué)、哈工大等;一些科研院所亦然,如中國(guó)電科49所、13所、26所、46所等。測(cè)試系統(tǒng)根據(jù)產(chǎn)品特點(diǎn)結(jié)構(gòu)和功能各異,其中,航天新銳公司在MEMS晶圓級(jí)測(cè)試系統(tǒng)的研制方面優(yōu)勢(shì)明顯,推出了LS1100系列MEMS晶圓片全參數(shù)自動(dòng)測(cè)試系統(tǒng)。測(cè)試產(chǎn)品包括流量計(jì)、加速度計(jì)、陀螺儀等。測(cè)試系統(tǒng)由探針臺(tái)和一系列測(cè)量?jī)x器,用于測(cè)量晶圓片的動(dòng)態(tài)參數(shù)和靜態(tài)參數(shù)。系統(tǒng)測(cè)試速率達(dá)到8s/芯片;圓片最大為6 in(1 in=2.54 cm);參量包括微小電容(最低10aF)、電阻(1Ω~1GΩ)、固有頻率(最高20kHz)、品質(zhì)因數(shù)(最高200000)、帶寬(最高10kHz)共5種,準(zhǔn)確度最高達(dá)±1%。
2. 專用探針卡
探卡是連接芯片管腳和標(biāo)準(zhǔn)儀器必要手段,是晶圓級(jí)芯片自動(dòng)測(cè)試的核心部分。
國(guó)際上,早在1995年,Beiley M等人提出了一種陣列結(jié)構(gòu)的薄膜式探卡,該探卡采用聚酰亞胺作為薄膜,并將探針做到薄膜當(dāng)中;2002年,由Park S等人提出利用了Ⅲ型硅片研制的懸臂梁結(jié)構(gòu)探卡,可以承受一定的接觸力,并能使探針針尖產(chǎn)生足夠的位移,因此,目前國(guó)際上通用的探卡形式為該種形式。
國(guó)內(nèi)而言,生產(chǎn)商使用MEMS懸臂梁式芯片測(cè)試探卡開展晶圓級(jí)測(cè)試工作。探卡的主要性能包括機(jī)械方面以及電學(xué)方面特性。探卡的機(jī)械特性主要通過(guò)檢測(cè)懸臂梁的彈性系數(shù)來(lái)測(cè)量。近年來(lái),納米壓痕技術(shù)已經(jīng)成為MEMS結(jié)構(gòu)機(jī)械特性測(cè)試的一個(gè)重要手段。利用Nano Indenter XP納米壓痕系統(tǒng),在探針針尖上施加一個(gè)逐步增大的接觸力,可得力—位移曲線,加載與卸載過(guò)程的力-位移曲線幾乎重合,說(shuō)明懸臂梁在整個(gè)受力過(guò)程中沒(méi)有產(chǎn)生塑性變形。利用半導(dǎo)體探針測(cè)試臺(tái)可以檢測(cè)探卡的電學(xué)特性。開路狀態(tài)時(shí),在相鄰兩個(gè)懸臂梁針尖上加上20 mV的直流電壓,測(cè)得漏電流僅為0.04 pA,即開路情況下相鄰懸臂梁探針之間的絕緣電阻高達(dá)500GΩ。而在探卡針尖相互短接時(shí),可以測(cè)得通路電阻約為1.6 Ω。也就是說(shuō),對(duì)于一個(gè)懸臂梁,其探卡背面的針尖到探卡正面的引線點(diǎn)的互聯(lián)電阻僅為0.8 Ω,這已達(dá)到目前芯片測(cè)試的基本要求。另外,利用一種半導(dǎo)體參數(shù)測(cè)試儀(HP4284A)測(cè)試了相鄰兩個(gè)探針引線焊盤之間的寄生電容,結(jié)果僅為0.02~0.03pF。綜上,國(guó)內(nèi)此類結(jié)構(gòu)的探卡在機(jī)械性能和電學(xué)性能方面均滿足MEMS晶圓級(jí)測(cè)試系統(tǒng)批量測(cè)試的要求。